

激光植錫球技術在倒裝芯片焊接的應用
紫宸激光植錫球技術在倒裝芯片焊接的應用
路透社12日引述知情人士消息稱,拜登政府計劃下個月擴大對美國企業向中國出口人工智能芯片與芯片制造設備的限制。而這次不再像是之前華為被芯片卡脖子一樣,這對我國的芯片企業也是一大發展機遇。我國有名專業人士解讀,美國的限制政策會干擾中國建立14納米及以下芯片生產線,導致中國企業在購買相關芯片生產設備時發生延遲,甚至買不到,這會對中國帶來現實性的影響。
不過也正是因為美國的打壓,中國芯片產業也在致力于建立基于自主科研技術的生產能力。前端GPU(圖形處理器)被禁止向中國出口,短期內對中國人工智能、高性能計算等方面會帶來一定影響,但中國目前已有約20家企業進行GPU的設計和研發。從這個角度來看,美國限制出口也意味著美國企業把這些市場拱手讓給正在快速發展的中國企業。

我們都知道,影響我國芯片制造發展的主要因素在于光刻機,目前這項技術掌握在國外少數的幾家企業手上,我國要自主研發打破被卡脖子,亟待國內科研人士的開發。芯片制造四大基本工藝包括:芯片設計、FPGA驗證、晶圓光刻顯影、蝕刻、芯片封裝等,晶片制作過程較為復雜,需經過濕洗、光刻、 離子注入、干蝕刻、等離子沖洗、熱處理、化學氣相淀積、物理氣相淀積、電鍍處理、化學/機械表面處理、晶圓測試等過程。除去光刻機的影響,其實各國之間的芯片制造工藝相差并不大,下面我們來看下芯片制造四大基礎工藝之一的芯片封裝焊接。
激光植錫球技術在倒裝芯片焊接領域的應用,無疑為微電子封裝行業帶來了革命性的變革。這項技術以其高精度、高效率及優越的焊接質量,正逐步成為前端電子產品制造中的主要工藝之一。隨著5G通信、人工智能、物聯網等技術的飛速發展,對芯片集成度、性能穩定性及生產效率提出了更高要求。由于倒裝芯片比BGA或CSP具有更小的外形尺寸、更小的球徑和球間距,他對植錫球工藝、基板技術、材料的兼容性、制造工藝,以及檢查設備和方法提出 了前所未有的挑戰。

倒裝芯片焊接技術是一種新興的微電子封裝技術,它將工作面(有源區面)上制有凸點電機的芯片朝下,與基板布線層直接鍵合。一般來說,這類器件有以下特點:
1、基材是硅;
2、電氣面及焊凸在器件下表面;
3、球間距一般為4-14milk、球徑為2.5-8mil、外形尺寸為1-27mm;
4、組裝在基板上后需要做底部填充。
其實,倒裝芯片之所以被稱之為“倒裝”,是相對于傳統的金屬線鍵合連接方式(Wire Bonding)與激光植球后的工藝而言的。傳統的通過金屬線鍵合與基板連接的芯片電面朝上(圖1),而倒裝芯片的電氣面朝下(圖2),相當于將前者翻轉過來,故稱為“倒裝”。在圓片(Wafer)上芯片植完球后(圖3),需要將其翻轉,送入貼片機以便于貼裝,也由于這一翻轉過程被稱為“倒裝芯片”。
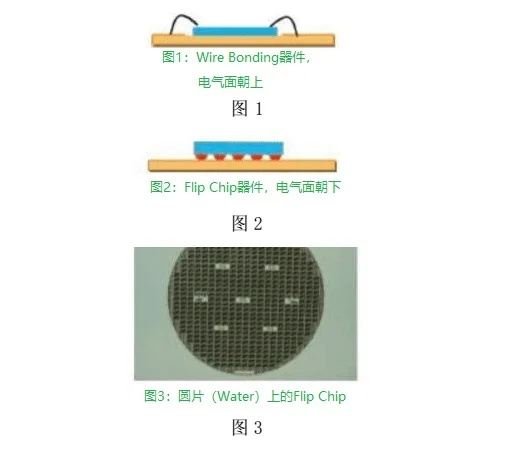
紫宸激光植錫球工藝介紹
紫宸激光的激光植錫球技術,通過精密控制激光束的能量密度與掃描路徑,能夠在極短的時間內,將微小至微米級的錫球精確無誤地植入到芯片焊盤上,形成穩定的電氣連接。這一過程不單減少了傳統手工植球帶來的誤差與污染,還明顯提升了焊接點的均勻性和可靠性,為芯片提供了更為穩固的支撐與信號傳輸通道。

更值得一提的是,紫宸激光的植錫球系統集成了先進的自動化與智能化技術,能夠實現大規模生產中的快速響應與靈活調整。系統內置的實時監測與反饋機制,確保每一顆錫球的植入都達到較優狀態,有效提升了整體生產線的良率與效率。同時,該技術還兼容多種材料體系與芯片尺寸,為不同領域、不同需求的電子產品制造商提供了廣闊的應用空間。



 瀏覽器自帶分享功能也很好用哦~
瀏覽器自帶分享功能也很好用哦~